
先進封裝製程
Advanced Packaging Process
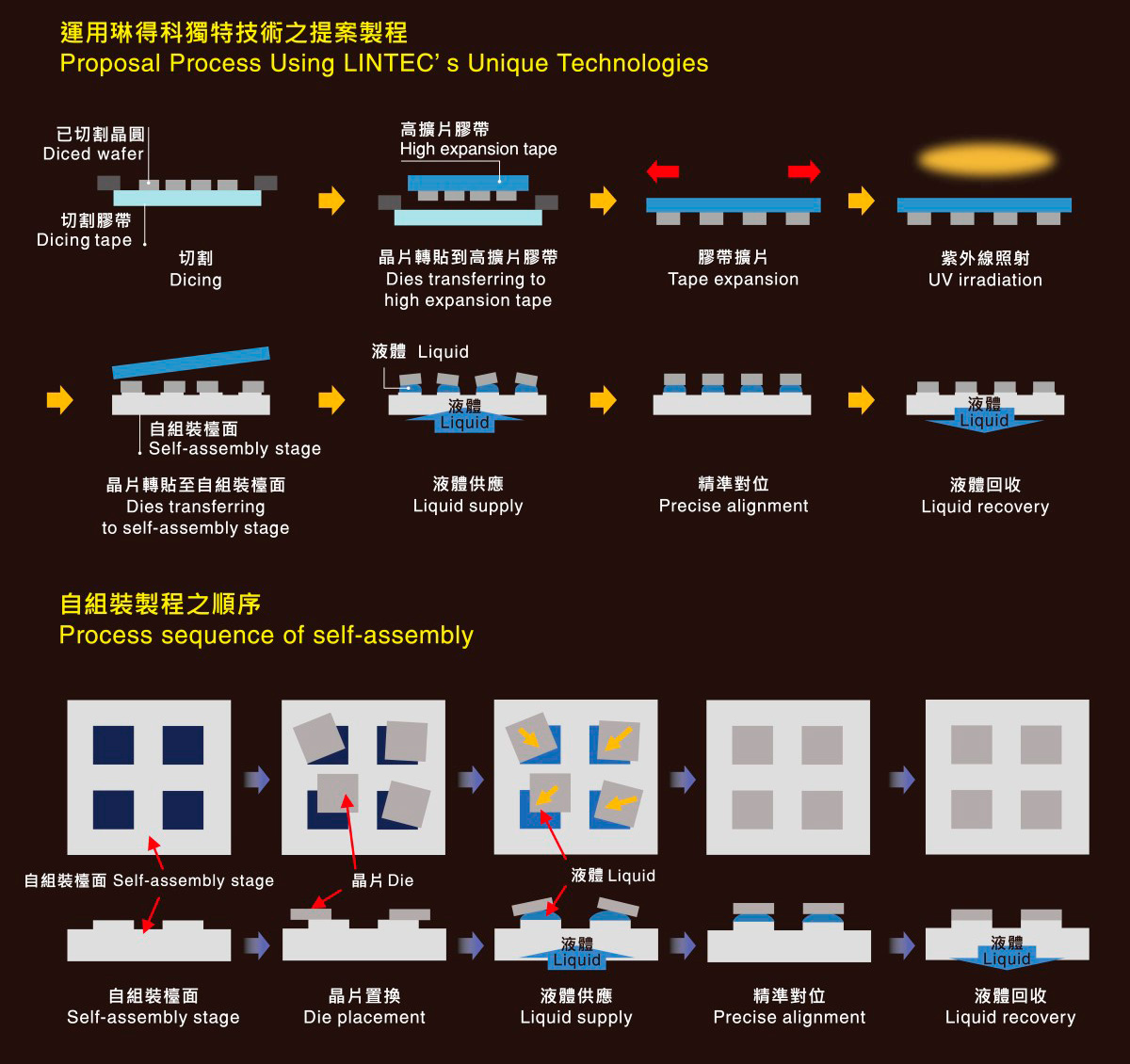
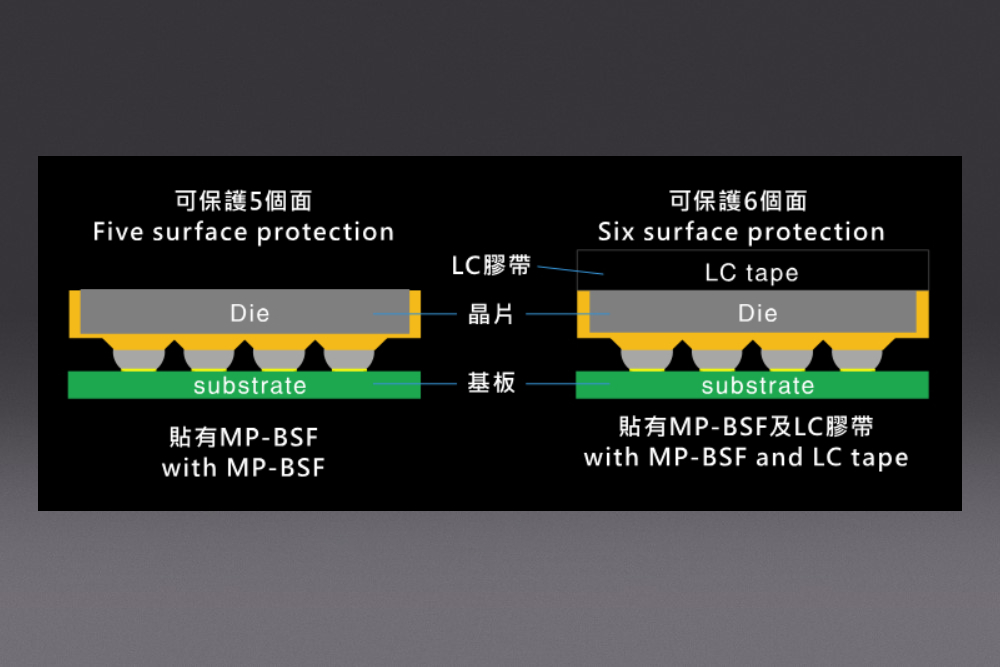
具備多重保護功能的錫球保護膠膜 (MP-BSF)Multiple Protect Bump Support Film (MP-BSF)
- 將具備多重保護功能的錫球保護膠膜貼於切半之晶圓上,可有5個面的保護功能
- 與LC膠帶貼合,則可有6個面的保護功能
- Five surface protection is possible by laminating MP-BSF to a half-cut wafer
- Six surface protection is possible by combining with LC tape
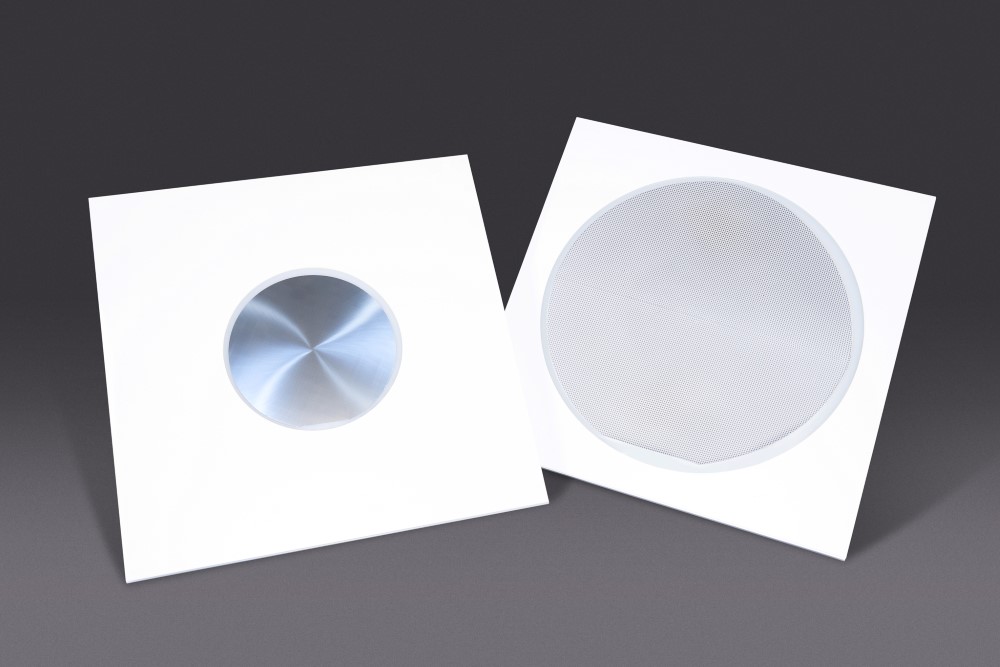
適用於扇出型晶圓級封裝之晶片置換技術 擴片製程 / 自組裝製程Die Placement Technologies for FO-WLP Expansion Process / Self-Assembly Process
琳得科提案的新製程結合膠帶擴片及自組裝技術,以實現精準的置換能力及優良的產出率。
To achieve both high placement accuracy and high throughput, LINTEC proposes a novel process that combines tape expansion technology and self-assembly technique.

紫外線硬化型 適用於高溫製程之耐熱膠帶UV Curable Heat-resistant Tape
-
適用於各種高溫製程中,固定、保護及搬運工作片之膠帶
- 可依客戶需求,提供不同款式之紫外線硬化型耐熱膠帶
- 具優良穩定性,高溫製程後容易撕離、不留殘膠 Tape offers superior performance with regards to temporary fix, protection and handing during various high temperature processes.
- Provide different types of UV curable heat-resistant tapes according to customer needs
- Excellent stability, easy to peel off and no adhesive residue after high temperature process
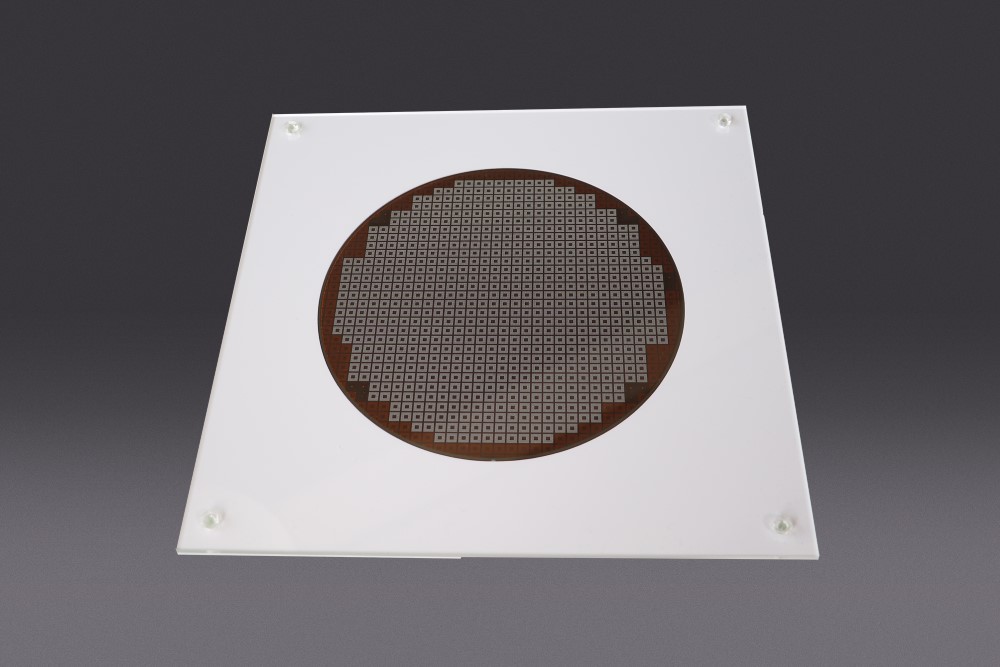
錫球保護膠膜Bump Support Film
-
錫球保護膠膜可應用於錫球晶圓,在半導體後段製程的不同步驟中帶來以下好處:
- 保護焊接處以提升錫球晶片的可靠度
- 減少刀片切割時造成的晶圓表面崩裂
- 改善薄型晶圓/易碎晶圓的搬運性
- 可用於包覆錫球/銅柱
- 可用於提升晶片強度 BSF can be applied to bump wafers for benefits in different steps throughout the semiconductor back end process.
- Can increase the reliability of bump chips by protecting the solder joint
- Decreases top side chipping caused during blade dicing
- Can be used to improve handling of thin/brittle wafers
- Can be used to embed bumps/Cu pillars
- Can be used to improve die strength

