
應用中心 / 機台設備
Application Center / Equipment


應用服務Service of Application Center
- 製程問題解決(製程優化)
- 機台功能介紹
- 新材料評估
- 日本研發評估支援
- Customer Claim Solving (optimize process)
- Machine Demonstration
- Evaluation for New Tape
- R&D Center in Japan Request Evaluation
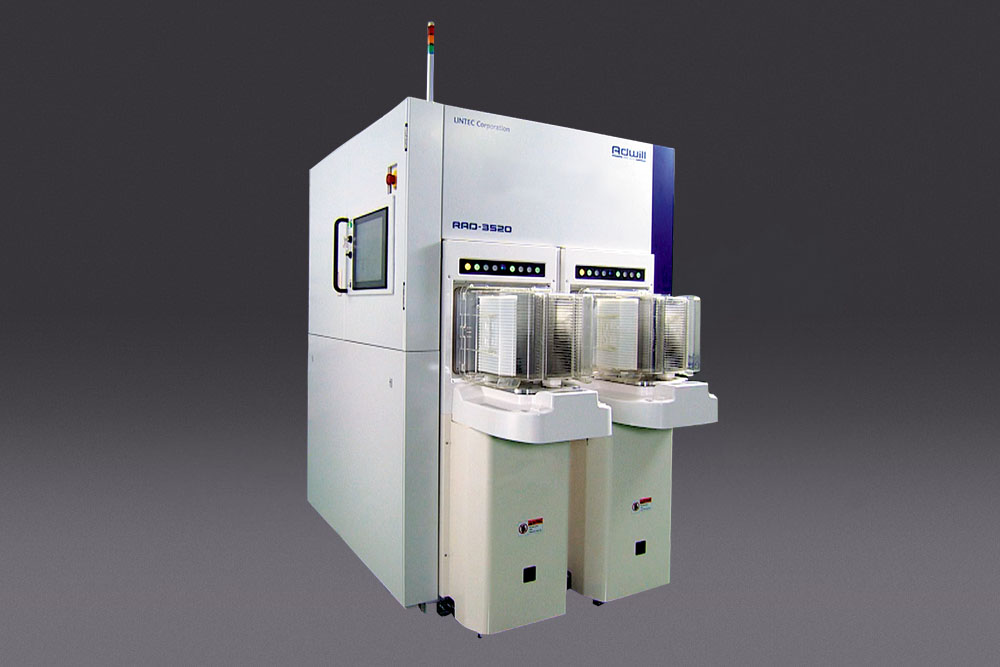
300 mm全自動研磨膠帶貼合機 RAD-3520F/12300 mm Fully-Automatic BG Tape Laminator RAD-3520F/12
- 透過膠帶張力控制及回報方式實現低張力貼合
- 使用多關節機械手臂進行三次元膠帶切割
- 採用獨特的貼合機構,實現 WLCSP 高精密性無氣泡的貼合作業
- Low-tension lamination by tape tension control unit and feedback control
- Three dimension cutting method by multi-jointed robot arm
- Accurate and void-less tape lamination to WLCSPs by uniquely developed laminating mechanism

300 mm全自動晶圓背面保護膠帶貼合機 RAD-3600F/12300 mm Fully-Automatic LC Tape Laminator RAD-3600F/12
- 透過獨自開發的貼合機構,實現高精度膠帶貼合
- 設備內採用Precut方式,避免切割刀接觸晶圓造成損傷
- 新選配:對應翹曲晶圓 (200 mm: 5 mm / 300 mm: 7 mm)
- Highly precise tape lamination is achieved with the uniquely developed laminating mechanism
- The in-line precut mechanism eliminates wafer edge damage caused by tape cutting along the wafer periphery
- New Option : Wafer warpage compatibility (200 mm : 5 mm / 300 mm : 7 mm)

300 mm全自動切割膠帶貼合機 RAD-2510F/12Sa300 mm Fully-Automatic Multifunction Wafer Mounter RAD-2510F/12Sa
- 以全面接觸式搬運晶圓,實現極薄晶圓穩定性搬運功能
- 透過本公司的研磨用保護膠帶剝離方式,可穩定地從極薄晶圓上剝離研磨用保護膠帶
- 選配:可對應無貼合背面研磨保護膠帶之晶圓(適用於WLCSP)
- 選配:可對應7 mm翹曲晶圓(如 : 晶圓尺寸300 mm)
- Stable wafer transfer by adopting full contact transfer of wafer with back grinding tape
- Our unique back grinding tape peeling method accomplishes stable peeling from ultra-thin wafers
- Option : Compatibility of wafer without back grinding tape for WLCSP wafer process
- Option : Compatibility of 7 mm warpage wafer (ex. 300 mm wafer)

300 mm全自動膠帶轉貼機RAD-2600F/12300 mm Fully-Automatic Remounter RAD-2600F/12
- 可於同個工作台上完成膠帶切割及轉貼步驟,使晶圓處理更加穩定
- 在切割膠帶轉貼至另一面前,事先將已貼合膠帶裁切成晶圓尺寸,使得膠帶之間不留殘膠
- 選配:切割膠帶 inline 預切割
- 選配:適用於 8 吋晶圓及鐵框
- 選配:晶圓貼合精度量測模組
- 選配:視覺系統(晶圓 ID 讀碼及條碼貼合系統)
- Tape cutting and remounting is performed at the same table for stable wafer handling
- The mounted tape is cut to wafer size before dicing tape is remounted on the opposite side, so there is no adhesion between the tapes
- Option : Dicing tape inline precut
- Option : 8 inch wafer and ring frame compatibility
- Option : Wafer mounting accuracy measurement unit
- Option : Vision system (wafer ID reader & barcode attachment system)

